Patents
Literature
47results about How to "Improve edge roughness" patented technology
Efficacy Topic
Property
Owner
Technical Advancement
Application Domain
Technology Topic
Technology Field Word
Patent Country/Region
Patent Type
Patent Status
Application Year
Inventor
Polymers and chemically amplified positive resist compositions
InactiveUS6156477AHigh resolutionDissolution contrast of a resist film is increasedPhotosensitive materialsRadiation applicationsPolymer sciencePhenyl group
A polymer comprising recurring units of formula (1) is provided wherein some hydrogen atoms of phenolic hydroxyl groups and / or carboxyl groups are replaced by acid labile groups. The polymer is crosslinked with a crosslinking group having a C-O-C linkage resulting from reaction of some of the remaining phenolic hydroxyl groups and / or carboxyl groups with an alkenyl ether compound or halogenated alkyl ether compound. The amount of the acid labile group and the crosslinking group combined is on the average from more than 0 mol % to 80 mol % of the entirety of the phenolic hydroxyl group and carboxyl group. The polymer has Mw of 1,000-500,000. R1 is H or methyl, R2 is C1-C8 alkyl, R3 is H, R4 is -COOR5, C1-C5 alkyl or phenyl, or R3 and R4, taken together, may form -COOCO-, R5 is H or C1-C8 alkyl, x and y are integers satisfying x+y< / =5, p and q are positive numbers satisfying p+q=1 and 0<q / (p+q)< / =0.9. A chemically amplified positive resist composition comprising the polymer as a base resin has high sensitivity and resolution and forms resist patterns having plasma etching resistance, heat resistance, overhang prevention, and dimensional controllability.
Owner:SHIN ETSU CHEM IND CO LTD
Chemically amplified positive resist composition, pattern forming method, and method for preparing polymer having a crosslinking group
InactiveUS6114462AHigh resolutionDissolution contrast of a resist film is increasedRadiation applicationsPhotosensitive materials for photomechanical apparatusOrganic solventPhotoacid generator
A chemically amplified positive resist composition contains (A) an organic solvent, (B) a base resin in the form of a polymer having at least one acid labile group and crosslinked within a molecule and / or between molecules with a crosslinking group having a C-O-C linkage, the polymer having a weight average molecular weight of 1,000-500,000, (C) a photoacid generator, (D) a basic compound, and (E) an aromatic compound having a group 3BOND C-COOH in a molecule. The composition has a high alkali dissolution contrast, high sensitivity and high resolution.
Owner:SHIN ETSU CHEM IND CO LTD
Effect pigments
InactiveUS20130164356A1Flat surfaceReduce overall form factorCosmetic preparationsMake-upRefractive indexPrinting ink
Owner:MERCK PATENT GMBH
Partially hydrogenated polymers and chemically amplified positive resist compositions
InactiveUS6033828AHigh resolutionDissolution contrast of a resist film is increasedRecord information storageSilver halide emulsionsResistHydroxy compound
A polymer comprising recurring units of formula (1) is provided wherein some of the hydrogen atoms of phenolic hydroxyl groups and / or alcoholic hydroxyl groups are replaced by acid labile groups. The polymer is crosslinked within a molecule and / or between molecules with a crosslinking group having a C-O-C linkage resulting from reaction of some of the remaining phenolic hydroxyl groups and / or alcoholic hydroxyl groups with an alkenyl ether compound or halogenated alkyl ether compound. The amount of the acid labile group and the crosslinking group combined is on the average from more than 0 mol % to 80 mol % of the entirety of the phenolic hydroxyl group and alcoholic hydroxyl group. The polymer has Mw of 1,000-500,000. R1 is H or methyl, R2 is C1-C8 alkyl, letter x is 0 or a positive integer, y is a positive integer, x+y< / =5, letters p and q are positive numbers satisfying p+q=1 and 0<q / (p+1)< / =0.9. A chemically amplified positive resist composition comprising the polymer as a base resin has high sensitivity and resolution and forms resist patterns having plasma etching resistance, heat resistance, overhang prevention, and dimensional controllability.
Owner:SHIN ETSU CHEM IND CO LTD
Polymers chemically amplified positive resist compositions, and patterning method
InactiveUS6027854AImproved in resolution and latitude of exposure and process adaptabilityEasy to usePhotosensitive materialsRadiation applicationsResistPlasma etching
A polymer comprising recurring units of formula (1) is provided wherein some hydrogen atoms of phenolic hydroxyl groups and / or alcoholic hydroxyl groups and / or carboxyl groups are replaced by acid labile groups. The polymer is crosslinked with a crosslinking group having a C-O-C linkage resulting from reaction of some of the remaining alcoholic hydroxyl groups and / or carboxyl groups with an alkenyl ether compound or halogenated alkyl ether compound. The amount of the acid labile group and the crosslinking group combined is on the average from more than 0 mol % to 80 mol % of the entirety of the phenolic hydroxyl group, alcoholic hydroxyl group and carboxyl group. The polymer has Mw of 1,000-500,000. R1 is H or methyl, R2 is C1-C8 alkyl, R3 is a divalent C1-C18 hydrocarbon group which may have a hetero atom, R4 and R5 are H or monovalent C1-C18 hydrocarbon groups which may have a hetero atom, x and y are integers satisfying x+y< / =5, x', y' and z' are integers satisfying x'+y'+z'< / =5, p, q and r are numbers satisfying 0< / =p< / =0.4, 0< / =q< / =0.4, 0.01< / =p+q< / =0.8, and p+q+r=1. A chemically amplified positive resist composition comprising the polymer as a base resin has high sensitivity, high resolution, a wide latitude of exposure, and process adaptability and forms resist patterns having plasma etching resistance and heat resistance.
Owner:SHIN ETSU CHEM IND CO LTD
Chemically amplified positive resist composition, pattern forming method, and method for preparing polymer having a crosslinking group
InactiveUS6312869B1High resolutionImprove stabilityPhotosensitive materialsRadiation applicationsOrganic solventDissolution
A chemically amplified positive resist composition contains (A) an organic solvent, (B) a base resin in the form of a polymer having at least one acid labile group and crosslinked within a molecule and / or between molecules with a crosslinking group having a C-O-C linkage, the polymer having a weight average molecular weight of 1,000-500,000, (C) a photoacid generator, (D) a basic compound, and (E) an aromatic compound having a group =C-COOH in a molecule. The composition has a high alkali dissolution contrast, high sensitivity and high resolution.
Owner:SHIN ETSU CHEM IND CO LTD
Preparation method of photoresist film-forming resin and photoresist composition thereof
ActiveCN112679653AReduce absorptionImprove permeabilityPhotosensitive materials for photomechanical apparatusPolymer scienceLithography process
The invention relates to the technical field of photoresists, and discloses a photoresist film-forming resin and a preparation method of a photoresist composition thereof. The preparation method comprises the following steps: carrying out copolymerization reaction on a monomer A derived from fluorine-containing acrylate, a monomer B derived from cholic acid and a monomer C derived from alicyclic acrylate to prepare photoresist film-forming resin; the photoresist prepared from the resin is high in etching resistance, the adsorbability and the adhesion to a substrate are greatly improved, the photoresist is used for a 193nm immersion type photoetching process, the optimal resolution of the photoresist can reach 0.13 [mu]m, an image is clear, and the edge roughness is good.
Owner:GANSU HUALONG SEMICON MATERIAL TECH CO LTD
Method to form reduced dimension pattern with good edge roughness
InactiveUS20040214109A1Minimal edge roughnessImprove edge roughnessElectric discharge tubesElectrographic processes using photoelectrophoresisEngineeringHeat treating
As feature sizes approach 0.1 .mu.m or smaller, reduction of line edge roughness (LER) becomes increasingly important. Significant reductions in edge roughness have been achieved by applying a second Ebeam exposure after the initial one thatis used to define the pattern. After this second blanket exposure a longer heat treatment and a stronger development process than before are used. In addition to reducing edge roughness the disclosed treatment allows the CD to be reduced under tight control since the amount of CD reduction is proportional to the second Ebeam dosage.
Owner:HEADWAY TECH INC
Photoresist acid-producing resin monomer containing adamantane structure and synthesis method thereof
InactiveCN111138410APrevent acid diffusionImprove edge roughnessOrganic chemistryPhotomechanical apparatusComposite materialChemical synthesis
The invention discloses a photoresist acid-producing resin monomer containing an adamantane structure and a synthetic method thereof, belonging to the fields of chemical synthesis and photoetching materials. The photoresist acid-producing resin monomer has a structural general formula which is described in the specification. In the structural general formula, R1 is an alkyl group or a cycloalkyl group; R2 is one selected from the group consisting of a covalent bond, an alkyl group, a fluoroalkyl group, an oxygen atom-containing alkyl group and an oxygen atom-containing fluoroalkyl group; and R3 is hydrogen or a methyl group. The photoresist acid-producing resin monomer provided by the invention has the following advantages: through combination of a photoinduced acid-producing agent with resin, acid diffusion of the photoinduced acid-producing agent in the post-exposure drying process can be effectively prevented, and the edge roughness of a photoetching pattern is improved; in addition, the cation part of the resin monomer also has a degradable group, and the dissolving speed difference of the resin monomer in a developing solution before and after exposure is increased, so the resolution ratio is improved.
Owner:上海博栋化学科技有限公司
Resist composition and patterning process
ActiveUS20190258160A1Improve stabilityHigh resolutionSemiconductor/solid-state device manufacturingPhotosensitive material processingAlcoholHydrolysate
A resist composition is provided comprising (A) a metal compound having formula (A-1), a hydrolysate or hydrolytic condensate thereof, or the reaction product of the metal compound, hydrolysate or hydrolytic condensate thereof with a di- or trihydric alcohol having formula (A-2), and (B) a sensitizer containing a compound having formula (B-1). The resist composition is adapted to change a solubility in developer upon exposure to high-energy radiation, has high resolution and sensitivity, and forms a pattern of good profile with minimal edge roughness after exposure.
Owner:SHIN ETSU CHEM IND CO LTD
Sulfonium sulfonate salt photoacid generator synthesized from cedrol and synthesis method for sulfonium sulfonate salt photoacid generator
PendingCN111138408AImprove edge roughnessReduce line width roughnessSulfonic acids salts preparationPhotosensitive materials for photomechanical apparatusChemical synthesisTetramethylene sulfoxide
The invention discloses a sulfonium sulfonate salt photoacid generator synthesized from cedrol and a synthesis method for the sulfonium sulfonate salt photoacid generator, belonging to the fields of chemical synthesis and photoetching materials. The photoacid generator has a structural general formula which is described in the specification. In the structural general formula, R1 is one selected from the group consisting of groups which are described in the specification; and R2 is one selected from the group consisting of a covalent bond, an alkyl group, a cycloalkyl group, an ester group-containing alkyl group and a fluorine-containing alkyl group. The synthesis method for the photoacid generator comprises the following steps: allowing the cedrol to react with a sulfonate compound so as to obtain an intermediate; and allowing the intermediate to react with (cyclohexyl-1,5-dienyloxy)-trimethyl-silane, tetramethylene sulfoxide and trifluoroacetic anhydride so as to obtain the sulfoniumsulfonate salt photoacid generator. According to the invention, a raw material, namely the cedrol has large molecular weight, so the photoacid generator formed by the cedrol also has large molecular weight; diffusion of the photoacid generator can be reduced; and improvement of the edge roughness, reduction of the line width roughness and improvement of the resolution ratio are facilitated.
Owner:上海博栋化学科技有限公司
Positive resist composition and pattern forming process
ActiveUS20200192221A1High sensitivityHigh resolutionPhotosensitive material processingPolymer scienceMaterials science
A positive resist composition comprising a base polymer comprising recurring units having a nitrogen-containing tertiary ester structure exhibits a high sensitivity, high resolution, low edge roughness (LER, LWR) and small size variation, and forms a pattern of good profile after exposure and development.
Owner:SHIN ETSU CHEM IND CO LTD
Sulfonium sulfonate salt photoacid generator synthesized from patchouli alcohol and synthesis method for sulfonium sulfonate salt photoacid generator
PendingCN111138405AReduce spreadHigh molecular weightOrganic chemistry methodsSulfonic acids salts preparationChemical synthesisSilanes
The invention discloses a sulfonium sulfonate salt photoacid generator synthesized from patchouli alcohol and a synthesis method for the sulfonium sulfonate salt photoacid generator, belonging to thefields of chemical synthesis and photoetching materials. The photoacid generator has a structural general formula which is described in the specification. In the structural general formula, R1 is oneselected from the group consisting of groups which are described in the specification; and R2 is one selected from the group consisting of an alkyl group, a cycloalkyl group, a heteroalkyl group, a heterocycloalkyl group, an ester group-containing alkyl group and a fluorine-containing alkyl group. The synthesis method for the photoacid generator comprises the following steps: allowing the patchouli alcohol to react with a sulfonate compound so as to obtain an intermediate; allowing the intermediate to react with (cyclohexyl-1,5-dienyloxy)-trimethyl-silane, tetramethylene sulfoxide and trifluoroacetic anhydride so as to obtain the sulfonium sulfonate salt photoacid generator. According to the invention, a raw material, namely the patchouli alcohol adopted in the method provided by the invention has large molecular weight, so the photoacid generator formed by the patchouli alcohol also has large molecular weight; diffusion of the photoacid generator can be reduced; and improvement of theedge roughness, reduction of the line width roughness and improvement of the resolution ratio are facilitated.
Owner:上海博栋化学科技有限公司
Sulfonium sulfonate salt photoacid generator synthesized from guaiacol and synthesis method for sulfonium sulfonate salt photoacid generator
PendingCN111138406AReduce spreadHigh molecular weightSulfonic acids salts preparationPhotosensitive materials for photomechanical apparatusChemical synthesisSilanes
The invention discloses a sulfonium sulfonate salt photoacid generator synthesized from guaiacol and a synthesis method for the sulfonium sulfonate salt photoacid generator, belonging to the fields ofchemical synthesis and photoetching materials. The photoacid generator has a structural general formula which is described in the specification. In the structural general formula, R1 is one selectedfrom the group consisting of groups which are described in the specification; and R2 is one selected from the group consisting of a covalent bond, an alkyl group, a cycloalkyl group, an ester group containing alkyl group and a fluorine-containing alkyl group. The synthesis method for the photoacid generator comprises the following steps: allowing the guaiacol to react with a sulfonate compound soas to obtain an intermediate; and allowing the intermediate to react with (cyclohexyl-1,5-dienyloxy)-trimethyl-silane, tetramethylene sulfoxide and trifluoroacetic anhydride so as to obtain the sulfonium sulfonate salt photoacid generator is obtained. According to the invention, a raw material, namely the guaiacol adopted in the method provided by the invention has large molecular weight, so the photoacid generator formed by the guaiacol also has large molecular weight; diffusion of the photoacid generator can be reduced; and improvement of the edge roughness, reduction of the line width roughness and improvement of the resolution ratio are facilitated.
Owner:上海博栋化学科技有限公司
Positive resist composition and patterning process
ActiveUS20210033971A1Improve decomposition efficiencyHigh sensitivityPhotosensitive material processingCoatingsPolymer scienceCarboxylic acid
A positive resist composition comprising a base polymer comprising recurring units (a) of an ammonium salt of a carboxylic acid having an iodized or brominated hydrocarbyl group and recurring units (b1) having an acid labile group-substituted carboxyl group and / or recurring units (b2) having an acid labile group-substituted phenolic hydroxyl group has a high sensitivity and resolution and forms a pattern of good profile with reduced edge roughness and improved dimensional uniformity.
Owner:SHIN ETSU CHEM IND CO LTD
Photoresist resin monomer synthesized from hexahydro-1H-indene-1,3 (2H)-dione, and synthesis method thereof
PendingCN111138287AImprove corrosion resistanceImprove solubilityPreparation from carboxylic acid halidesOrganic compound preparationChemical synthesisAlkane
The invention discloses a photoresist resin monomer synthesized from hexahydro-1H-indene-1,3 (2H)-dione, and a synthesis method thereof, and belongs to the technical fields of chemical synthesis and photoetching. The structural general formula of the photoresist resin monomer is represented by formula I shown in the description; and in the formula I, R1 is saturated alkane or cycloalkane, and R2 is hydrogen or a methyl group. The synthesis method comprises the following steps: carrying out a Grignard reaction on hexahydro-1H-indene-1,3(2H)-dione and an alkyl Grignard reagent or a cycloalkyl Grignard reagent under the protection of an inert gas, adding water for quenching after the Grignard reaction is finished, and carrying out post-treatment purification to obtain an intermediate; and carrying out an esterification reaction on the intermediate and acryloyl chloride or methacryloyl chloride, and carrying out post-treatment purification after the esterification reaction is finished in order to obtain the resin monomer. The resin monomer is a degradable resin monomer, and polymer resin containing the resin monomer has good etching resistance and can improve the resolution of photoresist photoetching patterns.
Owner:上海博栋化学科技有限公司
Photoresist resin monomer synthesized from carboxylic acid compound and synthesis method thereof
InactiveCN111100007AImprove edge roughnessHigh-resolutionOrganic compound preparationCarboxylic acid esters preparationVinyl etherChemical synthesis
The invention discloses a photoresist resin monomer synthesized from a carboxylic acid compound and a synthesis method of the photoresist resin monomer, and belongs to the field of chemical synthesisand photoetching materials. The structural general formula of the resin monomer is shown in the specification, wherein R is linear chain or branched chain alkyl. The synthesis method of the resin monomer comprises the following steps: carrying out esterification reaction on a vinyl ether alcohol compound and an acrylic acid compound to obtain an intermediate; and carrying out a reaction on the intermediate and 2, 5-dioxobicyclo[2.2. 2]octane-1, 4-dicarboxylic acid to generate the photoresist resin monomer. The resin monomer provided by the invention comprises an acetal structure and polycyclicand polyester structures, can prevent diffusion of a photoacid generator, improve edge roughness, increase contrast and improve resolution, has excellent etching resistance and fat solubility, and issimple and convenient in preparation method.
Owner:上海博栋化学科技有限公司
Radiation-sensitive resin composition
ActiveUS20100028800A1Improve stabilitySuppress fluctuationsPhotosensitive materialsRadiation applicationsMeth-Radiation sensitivity
It is intended to provide a radiation-sensitive resin composition, which comprises a radiation-sensitive acid generator excellent in resolution performance, heat stability, and storage stability, suppresses fluctuations in line width and deterioration in pattern profile attributed to standing waves, and produces a resist pattern improved in nano edge roughness and LEF. The radiation-sensitive resin composition is characterized by (A) a radiation-sensitive acid generator comprising: a sulfonium salt compound typified by 2,4,6-trimethylphenyldiphenylsulfonium 2,4-difluorobenzenesulfonate, 2,4,6-trimethylphenyldiphenylsulfonium 4-trifluoromethylbenzenesulfonate, or the like; and a sulfonimide compound. It is preferred that the composition should further comprise (B) a resin typified by a 4-hydroxystyrene / 4-t-butoxystyrene copolymer, a 4-hydroxystyrene / t-butyl (meth)acrylate, or the like.
Owner:JSR CORPORATIOON
Semiconductor structure and manufacturing method thereof
ActiveCN109712871AIncreased process windowLess uniformPhotomechanical apparatusSemiconductor/solid-state device manufacturingPhase splittingSemiconductor structure
The invention provides a semiconductor structure and a manufacturing method thereof. The manufacturing method comprises the following steps: S1, providing a substrate; S2, forming an induction structure on the surface of the substrate; S3, arranging a first block copolymer layer on the exposed surface of the substrate, and heating the first block copolymer layer for the first time to form a firstpre-split-phase structure layer comprising a first pre-block and a second pre-block; S4, forming at least one second split-phase structure layer on the surface, far away from the substrate, of the first pre-split-phase structure layer; S5, at least removing the fourth block, the second block and part of the substrate in sequence to form the substrate with a predetermined pattern; S6, at least removing the first block, the third block and the induction structure above the remaining substrate. According to the manufacturing method, a phase splitting process is carried out twice, and the manufactured structure has fewer defects, is better in uniformity and is lower in edge roughness.
Owner:INST OF MICROELECTRONICS CHINESE ACAD OF SCI
Degradable resin monomer synthesized from dicyclohexylketone and preparation method of degradable resin monomer
PendingCN112592277AEasy to operateImprove edge roughnessGroup 4/14 element organic compoundsPreparation from carboxylic acid halidesPolyesterPolymer science
The invention belongs to a degradable photoresist resin monomer, and discloses a degradable resin monomer synthesized from dicyclohexylketone and a preparation method of the degradable resin monomer.The structural formula of the resin monomer is shown in the description, wherein R is alkyl or heteroalkyl. The preparation method comprises the steps of protecting hydroxyl of a raw material I to obtain an intermediate II, wherein the raw material I comprises a structural general formula shown in the description, and R which is alkyl or heteroalkyl; reducing dicyclohexyl ketone under the condition of a Grignard reagent formed by the intermediate II and metal to obtain an intermediate III containing a hydroxyl group; deprotecting the intermediate III to obtain an intermediate IV containing twohydroxyl groups; and carrying out esterification reaction on the intermediate IV and an acrylic compound to obtain a resin monomer V. The resin monomer disclosed by the invention comprises a tert-butyl structure and a cyclic polyester structure, can improve the edge roughness, increase the contrast ratio and improve the resolution ratio, and has excellent etching resistance and fat solubility, and the preparation method is simple and convenient.
Owner:上海博栋化学科技有限公司
Degradable resin monomer synthesized from 1, 6-dioxaspiro [2.5] octane and preparation method thereof
InactiveCN112794834AImprove edge roughnessHigh-resolutionOrganic chemistryPhotosensitive materials for photomechanical apparatusPolyesterPolymer science
The invention belongs to a degradable photoresist resin monomer, and discloses a degradable resin monomer synthesized from 1, 6-dioxaspiro [2.5] octane and a preparation method thereof. The structural formula of the resin monomer is shown in the specification, and R is a linking bond or a linking group. The preparation method comprises the step of carrying out ring opening esterification on 1, 6-dioxaspiro [2.5] octane to generate the resin monomer. The resin monomer provided by the invention comprises a tert-butyl structure and a cyclic polyester structure, has improved edge roughness, increased contrast ratio and improved resolution ratio, and has excellent etching resistance and fat solubility, and the preparation method is simple and convenient.
Owner:上海博栋化学科技有限公司
Degradable photoresist resin monomer synthesized from oxaspiro [4.5] decane diketone and synthesis method thereof
PendingCN111777587AImprove corrosion resistanceImprove solubilityOrganic chemistryPhotosensitive materials for photomechanical apparatusAlkanePolymer science
The invention discloses a degradable photoresist resin monomer synthesized from oxaspiro [4.5] decane diketone and a synthesis method thereof, and relates to the field of photoresist resin. The structural formula of the resin monomer is shown in the specification, R1 is saturated alkane or cycloalkane, and R2 is hydrogen or methyl. The synthesis method comprises the following steps: reacting 6-oxaspiro [4.5] decane-8, 10-diketone (I) with an alkyl Grignard reagent or a cycloalkyl Grignard reagent to obtain an intermediate (II); reacting the intermediate (II) with acryloyl chloride or methacryloyl chloride under an alkaline condition to obtain a resin monomer (III); polymer resin formed by polymerizing the resin monomer and other resin monomers has better etching resistance, is beneficial to improving the edge roughness of a developed pattern, greatly improves the resolution of a photoetching pattern, and increases the solubility of the polymer resin in a fat-soluble solvent.
Owner:XUZHOU B&C CHEM CO LTD
Positive photosensitive composition
InactiveUS20070141513A1Positive photosensitiveIncrease roughnessPhotosensitive materialsRadiation applicationsActinic RaysAlicyclic Hydrocarbons
A positive photosensitive composition comprising (A) an acid generator that generates an acid upon irradiation of an actinic ray or radiation, (B) a resin that has a monocyclic or polycyclic alicyclic hydrocarbon structure and is decomposed by the action of an acid to increase solubility in an alkali developing solution, and (C) a specific basic compound.
Owner:FUJIFILM CORP
Photoresist resin monomer synthesized from alpha-cedrene and synthesis method thereof
InactiveCN111056947AHigh-resolutionImprove dissolution rateOrganic compound preparationCarboxylic acid esters preparationPolyesterChemical synthesis
The invention discloses a photoresist resin monomer synthesized from alpha-cedrene and a synthesis method thereof, which belong to the field of chemical synthesis and photoetching materials. The structural general formula of the photoresist resin monomer is shown in the specification, wherein R is a connecting bond or a heteroalkyl group. The synthesis method of the photoresist resin monomer comprises the following steps: reacting alpha-cedrene with peroxide to obtain a first intermediate with an epoxy structure; and carrying out a ring-opening esterification reaction on the first intermediateto obtain the photoresist resin monomer. The photoresist resin monomer provided by the invention comprises a tert-butyl structure and a polycyclic polyester structure, can improve the edge roughness,increase the contrast ratio and improve the resolution ratio, has excellent etching resistance and fat solubility, and is simple and convenient in preparation method.
Owner:上海博栋化学科技有限公司
Degradable photoresist resin monomer synthesized from furandione and synthesis method thereof
PendingCN111777579AImprove corrosion resistanceImprove solubilityOrganic chemistryPhotosensitive materials for photomechanical apparatusAlkaneFuran
The invention discloses a degradable photoresist resin monomer synthesized from furandione and a synthesis method thereof, and relates to the field of photoresist resin. The structural formula of theresin monomer is shown in the specification, R1 is saturated alkane or cycloalkane, and R2 is hydrogen or methyl. The synthesis method comprises the following steps: reacting furan-3, 4 (2H, 5H)-diketone (I) with an alkyl Grignard reagent or a naphthenic base Grignard reagent under the protection of inert gas, adding water for quenching after the reaction is finished, and carrying out aftertreatment and purification to obtain an intermediate (II); and 2, esterification reaction: reacting the intermediate (II) with acryloyl chloride or methacryloyl chloride under alkaline conditions, and carrying out post-treatment purification to obtain the resin monomer (III). Polymer resin formed by polymerizing the resin monomer and other resin monomers has better etching resistance, is beneficial to improving the edge roughness of a developed pattern, greatly improves the resolution of a photoetching pattern, and increases the fat solubility.
Owner:XUZHOU B&C CHEM CO LTD
Resist composition and patterning process using the same
ActiveUS10005868B2Increase contrastReduce the film shrinkagePhotomechanical exposure apparatusPhotosensitive material processingResistCarboxyl radical
The present invention provides a resist composition containing a base resin composed of a polymer compound having a repeating unit in which a hydrogen atom of a carboxyl group is substituted with one or more acid-labile groups selected from groups shown by the following general formulae (1-1) to (1-5),wherein R1 to R5 represent a linear, branched, or cyclic alkyl group having 1 to 4 carbon atoms, an alkenyl group having 2 to 4 carbon atoms, or an alkynyl group having 2 to 4 carbon atoms; R6 represents a hydroxyl group or an alkoxy group or acyloxy group having 1 to 6 carbon atoms; and “m” represents 1 or 2. There can be provided a resist composition that can improve the dissolution contrast of a resist film and reduce the film shrinkage after PEB, and a patterning process using the same.
Owner:SHIN ETSU CHEM IND CO LTD
Positive resist composition and patterning process
ActiveUS20200209747A1High decomposition efficiency of the acid generatorHigh sensitivityOrganic chemistryPhotomechanical exposure apparatusPolymer scienceOrganic chemistry
A positive resist composition comprising a base polymer comprising recurring units containing an optionally substituted amino group and iodine exhibits a high sensitivity, high resolution, low edge roughness (LER, LWR) and small size variation, and forms a pattern of good profile after exposure and development.
Owner:SHIN ETSU CHEM IND CO LTD
Sulfonium sulfonate photoacid generator synthesized from abietic acid and synthesis method of sulfonium sulfonate photoacid generator
InactiveCN112645849AGood etch resistanceExcellent solubilityOrganic compound preparationOrganic chemistry methodsImage resolutionLight source
The invention discloses a sulfonium sulfonate photoacid generator synthesized from abietic acid, and relates to the field of photoacid generators. The sulfonium sulfonate photoacid generator has a structural formula shown in the specification, in the formula, R1 is an oxygen-containing linking group, and R2 is a fluoroalkyl group. The photoacid generator can reduce the diffusion of the photoacid generator, improve the edge roughness, reduce the line width roughness and improve the resolution; the photoacid generator is more transparent under 193 nm, and exposure under a 193 nm light source is facilitated; the etching resistance is excellent; the photoacid generator is balanced in hydrophilicity and lipophilicity, has proper adhesive force and excellent solubility, is more uniform in dissolution, and is simple in synthetic route.
Owner:上海博栋化学科技有限公司
Effect pigments
InactiveUS20160068683A1High hiding powerMaintain good propertiesCosmetic preparationsToilet preparationsRefractive indexPrinting ink
Owner:MERCK PATENT GMBH
Photoresist film-forming resin and preparation method of photoresist composition
ActiveCN112679653BReduce absorptionImprove permeabilityPhotosensitive materials for photomechanical apparatusPolymer scienceLithography process
Owner:GANSU HUALONG SEMICON MATERIAL TECH CO LTD





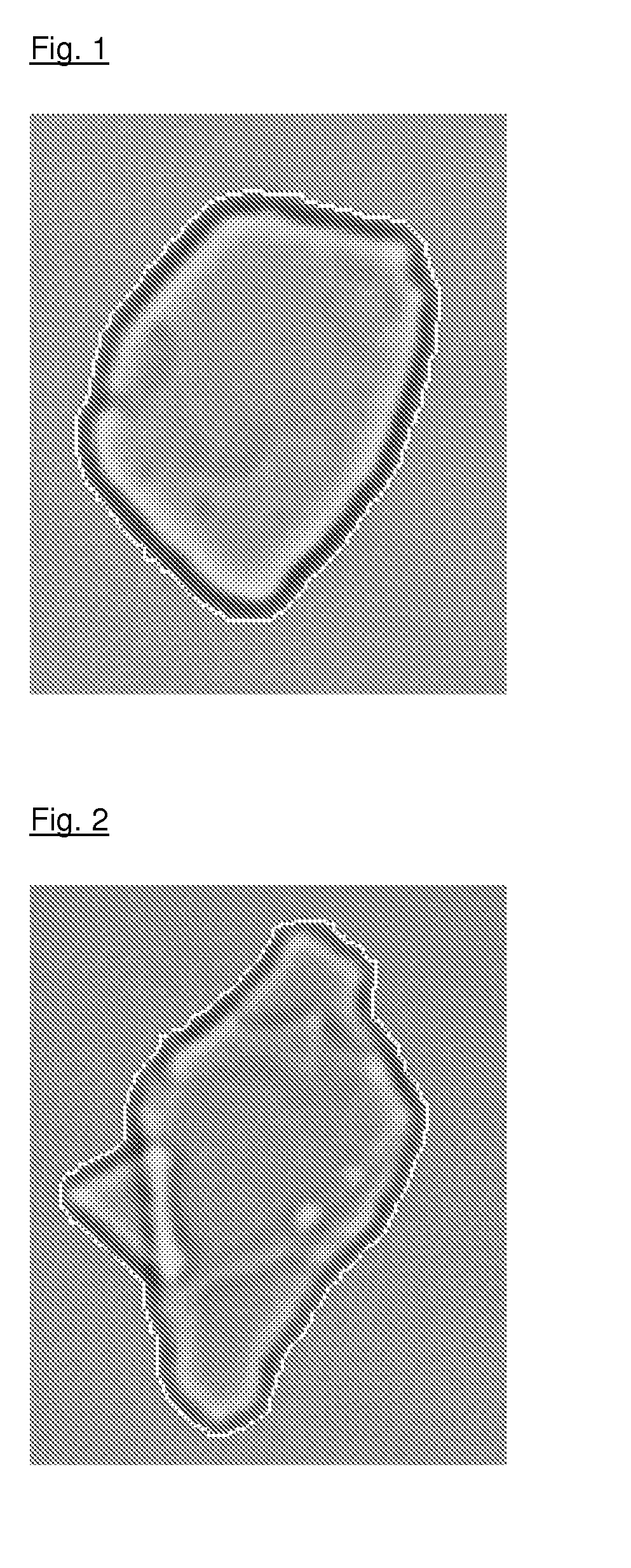



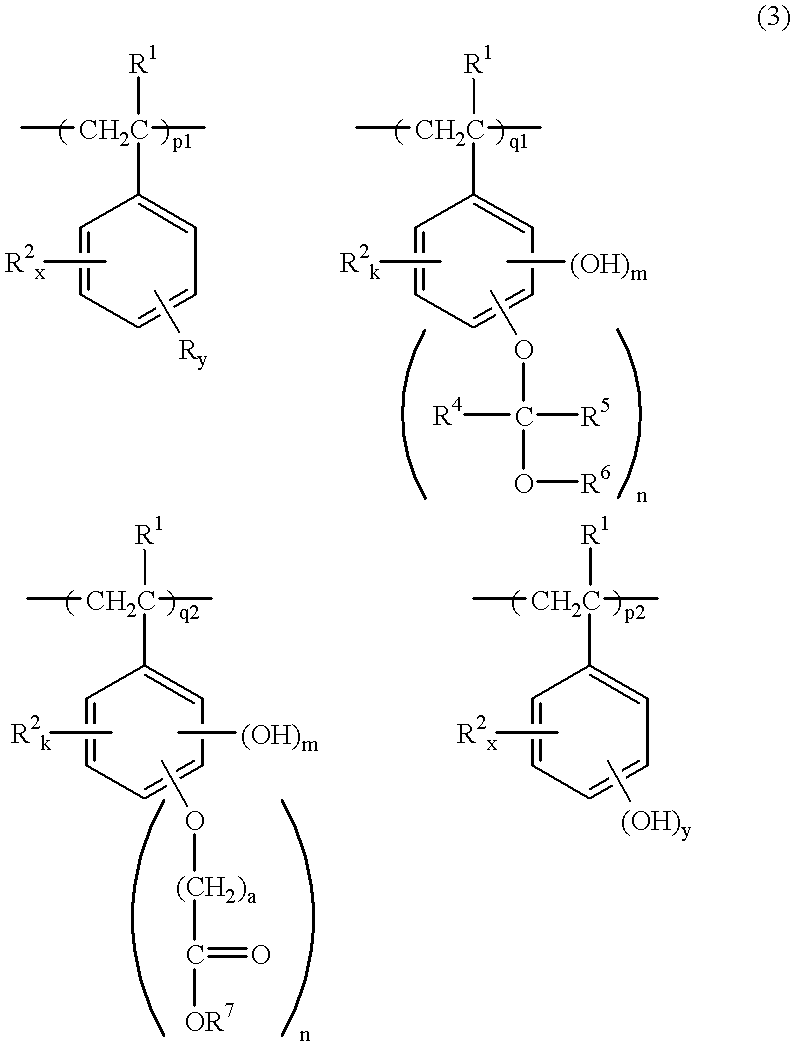
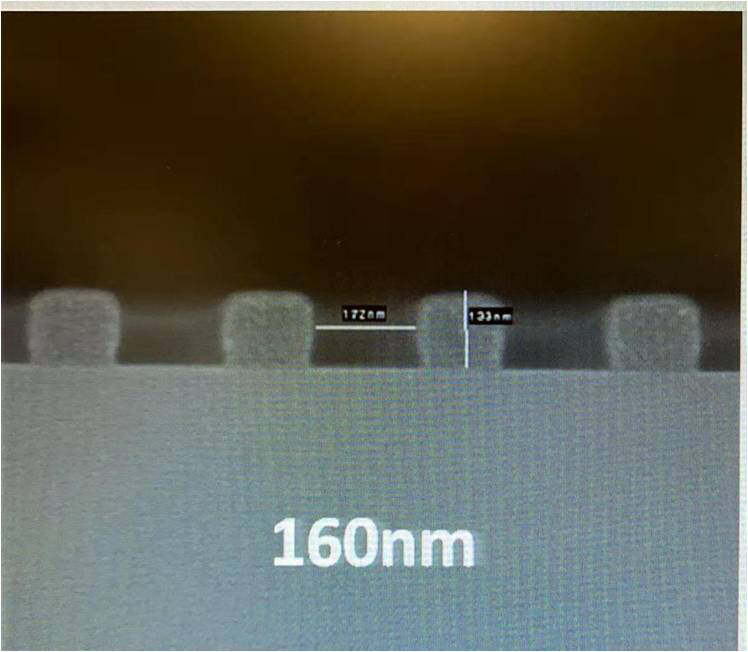



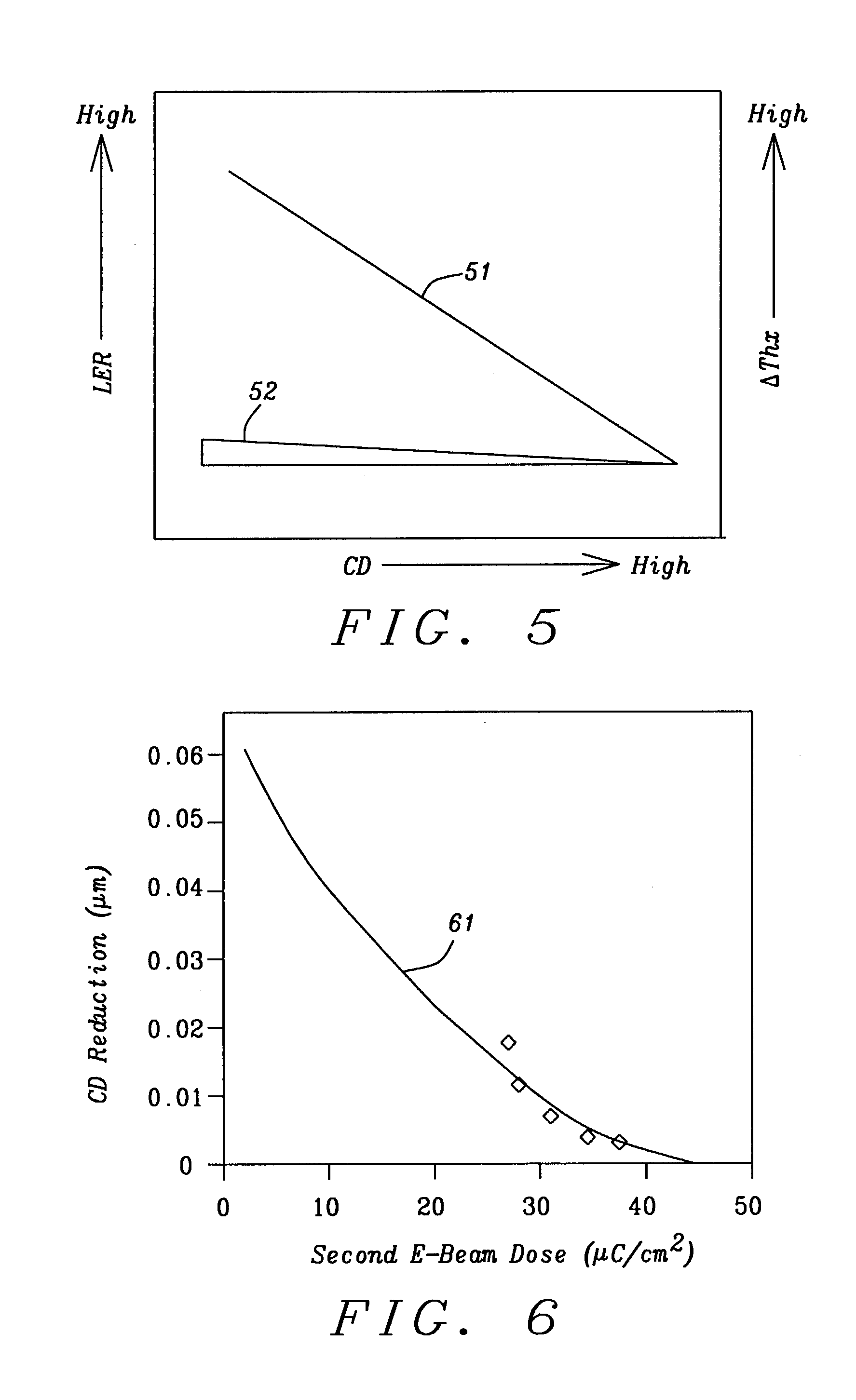



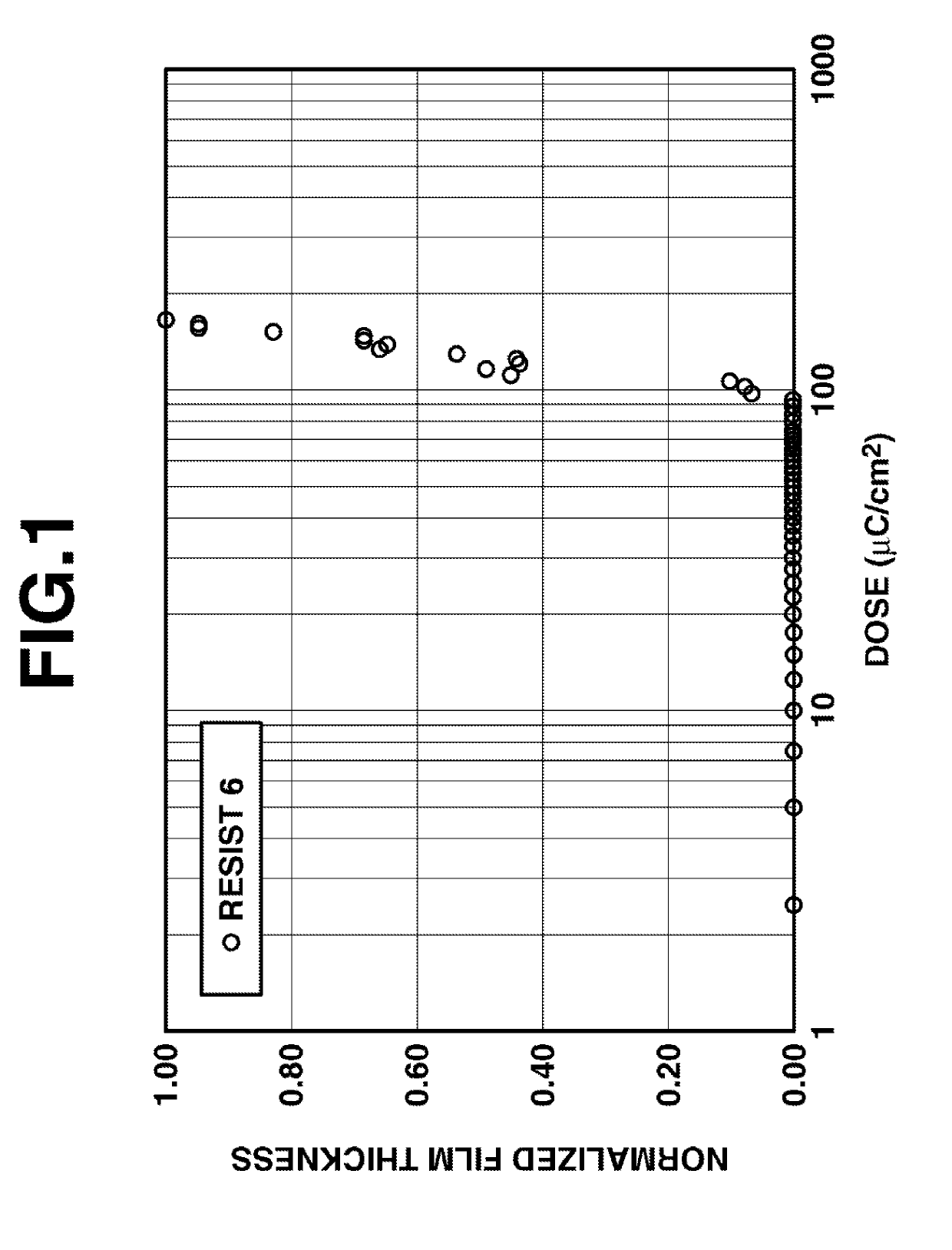















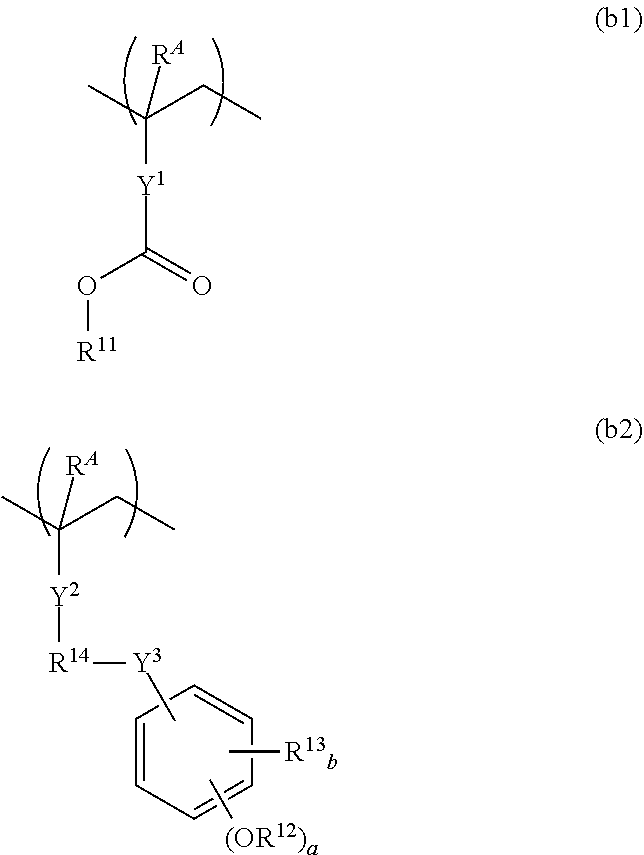







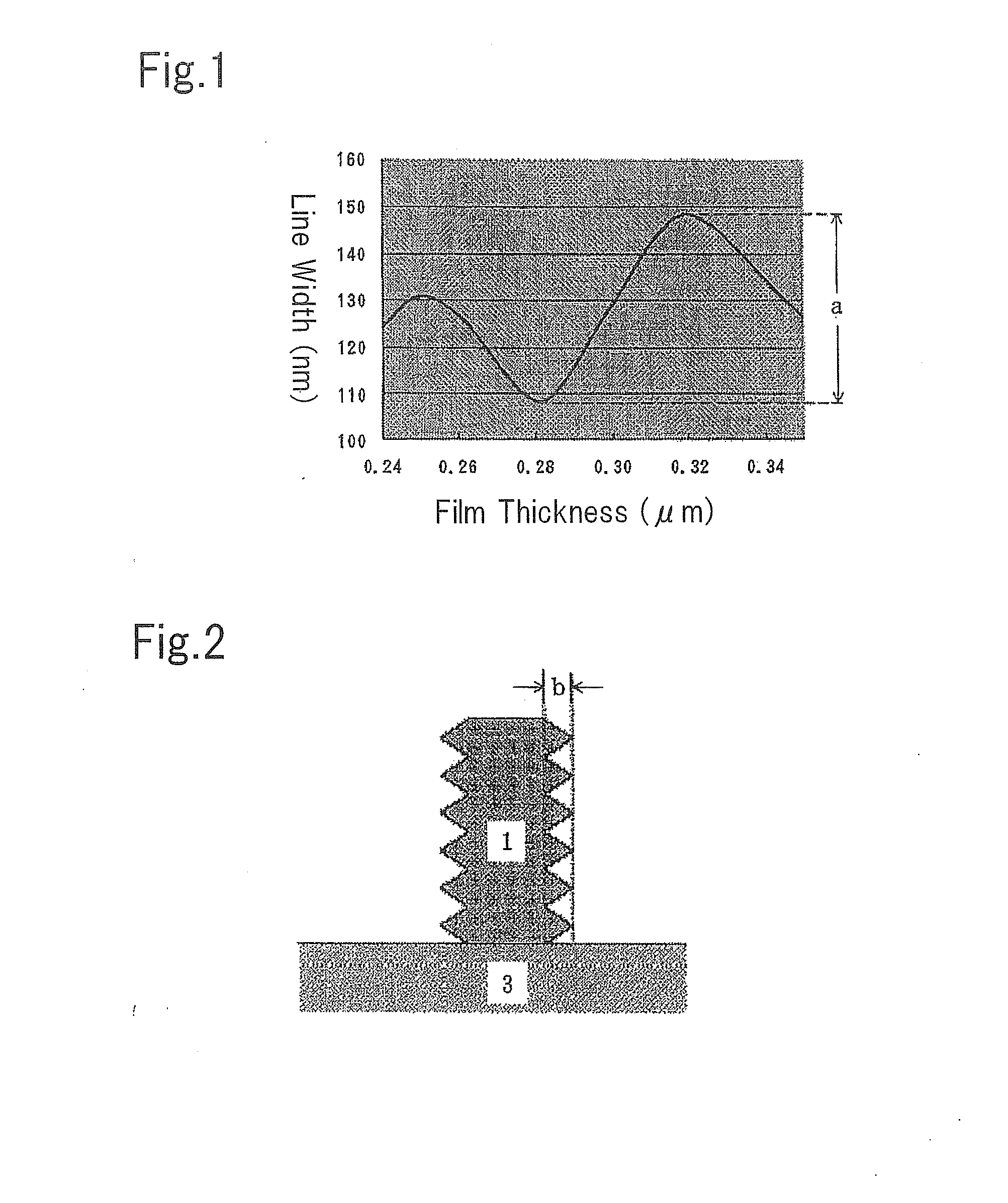








![Degradable resin monomer synthesized from 1, 6-dioxaspiro [2.5] octane and preparation method thereof Degradable resin monomer synthesized from 1, 6-dioxaspiro [2.5] octane and preparation method thereof](https://images-eureka.patsnap.com/patent_img/4c94e4ae-6df1-4eca-af73-686bfd5fc742/FDA0002856360270000014.png)
![Degradable resin monomer synthesized from 1, 6-dioxaspiro [2.5] octane and preparation method thereof Degradable resin monomer synthesized from 1, 6-dioxaspiro [2.5] octane and preparation method thereof](https://images-eureka.patsnap.com/patent_img/4c94e4ae-6df1-4eca-af73-686bfd5fc742/FDA0002856360270000021.png)
![Degradable resin monomer synthesized from 1, 6-dioxaspiro [2.5] octane and preparation method thereof Degradable resin monomer synthesized from 1, 6-dioxaspiro [2.5] octane and preparation method thereof](https://images-eureka.patsnap.com/patent_img/4c94e4ae-6df1-4eca-af73-686bfd5fc742/FDA0002856360270000022.png)
![Degradable photoresist resin monomer synthesized from oxaspiro [4.5] decane diketone and synthesis method thereof Degradable photoresist resin monomer synthesized from oxaspiro [4.5] decane diketone and synthesis method thereof](https://images-eureka.patsnap.com/patent_img/a0f6f4a6-1afd-4b35-97ec-656f0a9302c2/FDA0002545590100000012.png)
![Degradable photoresist resin monomer synthesized from oxaspiro [4.5] decane diketone and synthesis method thereof Degradable photoresist resin monomer synthesized from oxaspiro [4.5] decane diketone and synthesis method thereof](https://images-eureka.patsnap.com/patent_img/a0f6f4a6-1afd-4b35-97ec-656f0a9302c2/FDA0002545590100000013.png)
![Degradable photoresist resin monomer synthesized from oxaspiro [4.5] decane diketone and synthesis method thereof Degradable photoresist resin monomer synthesized from oxaspiro [4.5] decane diketone and synthesis method thereof](https://images-eureka.patsnap.com/patent_img/a0f6f4a6-1afd-4b35-97ec-656f0a9302c2/BDA0002545590110000021.png)