Patents
Literature
991 results about "Tetrazole" patented technology
Efficacy Topic
Property
Owner
Technical Advancement
Application Domain
Technology Topic
Technology Field Word
Patent Country/Region
Patent Type
Patent Status
Application Year
Inventor
Tetrazoles are a class of synthetic organic heterocyclic compound, consisting of a 5-member ring of four nitrogen atoms and one carbon atom. The simplest is tetrazole itself, CH₂N₄. They are unknown in nature.
Smokeless gas generant compositions
Thermally stable gas generant compositions incorporate a combination of one or more primary nonazide high-nitrogen fuels selected from a group including tetrazoles, bitetrazoles, and triazoles, and salts thereof; and one or more secondary nonazide high nitrogen fuels selected from azodicarbonamide and hydrazodicarbonamide. The primary and secondary fuels are combined with phase-stabilized ammonium nitrate that when combusted, results in a greater yield of gaseous products per mass unit of gas generant, a reduced yield of solid combustion products, lower combustion temperatures, and acceptable burn rates, thermal stability, and ballistic properties. These compositions are especially suitable for inflating air bags in passenger-restraint devices.
Owner:AUTOMOTIVE SYST LAB
Carbene metal complexes as OLED materials
ActiveUS20050258433A1High energyIndium organic compoundsSolid-state devicesTetrazoleOrganic light emitting device
An organic light emitting device having an anode, a cathode and an organic layer disposed between the anode and the cathode is provided. In one aspect, the organic layer comprises a compound having at least one zwitterionic carbon donor ligand. In another aspect, the organic layer comprises a carbene compound, including the following: In another aspect, the organic layer comprises a carbene compound, including: In another aspect, the organic layer comprises a carbene compound that includes a triazole ring and has the structure: In another aspect, the organic layer comprises a carbene compound that includes a tetrazole ring and has the structure:
Owner:SOUTHERN CALIFORNIA THE UNIV OF +1
N-(benzyl)aminoalkylcarboxylates, phosphinates, phosphonates and tetrazoles as Edg receptor agonists
The present invention encompasses compounds of Formula (I) as well as the pharmaceutically acceptable salts and hydrates thereof. The compounds are useful for treating immune mediated diseases and conditions, such as bone marrow, organ and tissue transplant rejection. Pharmaceutical compositions and methods of use are included.
Owner:MERCK SHARP & DOHME CORP
Nicotinamide acids, amides, and their mimetics active as inhibitors of PDE4 isozymes
Compounds useful as inhibitors of PDE4 in the treatment of diseases regulated by the activation and degranulation of eosinophils, especially asthma, chronic bronchitis, and chronic obstructuive pulmonary disease, of the formula: wherein j is 0 or 1, k is 0 or 1, m is 0, 1, or 2; n is 1 or 2; A is selected from the partial Formulas: where q is 1, 2, or 3, W3 is -O-; -N(R9)-; or -OC(=O)-; R7 is selected from -H; -(C1-C6) alkyl, -(C2-C6) alkenyl, or -(C2-C6) alkynyl substituted by 0 to 3 substituents R10; -(CH2)u-(C3-C7) cycloalkyl where u is 0, 1 or 2, substituted by 0 to 3 R10; and phenyl or benzyl substituted by 0 to 3 R14; R8 is tetrazol-5-yl; 1,2,4-triazol-3-yl; 1,2,4-triazol-3-on-5-yl; 1,2,3-triazol-5-yl; imidazol-2-yl; imidazol-4-yl; imidazolidin-2-on-4-yl; 1,3,4-oxadiazolyl; 1,3,4-oxadiazol-2-on-5-yl; 1,2,4-oxadiazol-3-yl; 1,2,4-oxadiazol-5-on-3-yl; 1,2,4-oxadiazol-5-yl; 1,2,4-oxadiazol-3-on-5-yl; 1,2,5-thiadiazolyl; 1,3,4-thiadiazolyl; morpholinyl; parathiazinyl; oxazolyl; isoxazolyl; thiazolyl; isothiazolyl; pyrrolyl; pyrazolyl; succinimidyl; glutarimidyl; pyrrolidonyl; 2-piperidonyl; 2-pyridonyl; 4-pyridonyl; pyridazin-3-onyl; pyridyl; pyrimidinyl; pyrazinyl; pyridazinyl; indolyl; indolinyl; isoindolinyl; benzo[b]furanyl; 2,3-dihydrobenzofuranyl; 1,3-dihydroisobenzofuranyl; 2H-1-benzopyranyl; 2-H-chromenyl; chromanyl; benzothienyl; 1H-indazolyl; benzimidazolyl; benzoxazolyl; benzisoxazolyl; benzothiazolyl; benzotriazolyl; benzotriazinyl; phthalazinyl; 1,8-naphthyridinyl; quinolinyl; isoquinolinyl; quinazolinyl; quinoxalinyl; pyrazolo[3,4-d]pyrimidinyl; pyrimido[4,5-d]pyrimidinyl; imidazo[1,2-a]pyridinyl; pyridopyridinyl; pteridinyl; or 1H-purinyl; or A is selected from phosphorous and sulfur acid groups; W is -O-; -S(=O)t-, where t is 0, 1, or 2; or -N(R3)-; Y is =C(R1a)-, or -[N<custom-character file="US20020111495A1-20020815-P00900.TIF" wi="20" he="20" id="custom-character-00001" / >(O)k] where k is 0 or 1; R4, R5 and R6 are (1) -H; provided that R5 and R6 are not both -H at the same time, -F; -Cl; -(C2-C4) alkynyl; -R16; -OR16; -S(=O)pR16; -C(=O)R16, -C(=O)OR16, -C(=O)OR<highlight><sup
Owner:PFIZER INC
Tetrazoyl oxime derivative and agrochemical containing the same as active ingredient
InactiveCN1553907AAdequate control effectGood treatment effectBiocideOrganic chemistryTetrazoleAcyl group
The present invention provides a tetrazoyloxime derivative which is less likely to cause chemical injury to useful plants and is also superior in chemical efficacy to a conventional hetero ring-substituted oxime derivative. A tetrazoyloxime derivative represented by the general formula (1): <CHEM> X represents a hydrogen atom, a halogen atom, an alkyl group, an alkoxy group, a cyano group, a methanesulfonyl group, a nitro group, a trifluoromethyl group, or an aryl group; A represents a 1-alkyltetrazoyl-5-yl group or a 5-alkyltetrazoyl-1-yl group; and Het represents a pyridyl group having a substituent or a thiazoyl group having a substituent, and a plant disease controlling agent containing the same as an active ingredient are disclosed.
Owner:NIPPON SODA CO LTD
Peptide derivatives having β-secretase inhibitory activity
Provided are excellent β-secretase inhibitors, that is, compounds represented by the general formula (1) or prodrugs thereof:wherein A is amino or protected amino; B1 and B2 are each a single bond, alkylene of 1 to 3 carbon atoms, or the like; D is a single bond, —NHCO, or the like; E is —COOH, tetrazole ring, or the like; n is an integer of 1 to 3; m is an integer of 1 to 3; G is hydroxyl, a group represented by the general formula (2), or the like:in which Z is —NH, -Asp-Ala-NH—, -Asp-Ala-, -Asp-NH—, or the like; L is a 5-to 10-membered ring optionally containing a heteroatom and / or unsaturated bond; X is —COOH, tetrazole ring, or the like; Y is hydrogen, —COOH, or the like; and k is an integer of 1 to 4; and R1, R2, and R3 are each alkyl of 1 to 6 carbon atoms, or the like.
Owner:KISO
Phenyl oxo-acetic acids useful in the treatment of insulin resistance and hyperglycemia
This invention provides compounds of Formula I having the structure wherein:A is O, S, or N;B is —(CH2)m—, —CH(OH)—, or carbonyl;R1 is hydrogen, halogen, alkyl of 1-6 carbon atoms, alkoxy of 1-6 carbon atoms, or trifluoromethyl;R2 is alkyl of 1-18 carbon atoms, aryl of 6-10 carbon atoms, arylalkyl of 7-15 carbon atoms, Het-alkyl wherein the alkyl moiety is 1-6 carbon atoms;Het is R2a is alkylene of 1-3 carbon atoms;G is oxygen, sulfur, or nitrogen;R3, R4 are each, independently, hydrogen, halogen, alkyl of 1-3 carbon atoms, aryl of 6-10 carbon atoms or a heterocyclic ring of 5 to 7 ring atom containing 1 to 3 heteroatoms selected from oxygen, nitrogen, sulfur;R5 is hydrogen, alkyl of 1-6 carbon atoms, —CH(R7)R8, —C(CH2)nCO2R9, —C(CH3)2CO2R9, —CH(R7)(CH2)nCO2R9, or CH(R7)C6H4CO2R9;R6 is hydrogen, halogen, alkyl of 1-6 carbon atoms, or —OR5;m=1-6;n=1-6;R7 is hydrogen, alkyl of 1-6 carbon atoms, aryl of 6-10 carbon atoms, or arylalkyl of 7-15 carbon atoms;R8 is —CO2R10, —CONHR10, tetrazole, or —PO3;R9 and R10 are each, independently, hydrogen, alkyl of 1-6 carbon atoms, aryl of 6-10 carbon atoms, or arylalkyl of 7-15 carbon atoms;or a pharmaceutically acceptable salt thereof, which are useful in treating metabolic disorders related to insulin resistance or hyperglycemia.
Owner:WYETH LLC
Extinguishment combination with hot gas sol
The invention provides ''a hot aerosol fire-extinguishing composition'' and relates to an oxidative magnesium salt hot aerosol fire-extinguishing composition represented by anhydrous magnesium nitrate. The composition is characterized in that the composition can be magnesium nitrate, magnesium carbonate, or other magnesium salt, and can also be a compound of magnesium nitrate, or other magnesium salt with potassium nitrate, strontium nitrate, or other potassium salt or strontium salt; a reducer can be one of or the combination of a plurality of ammonium carbamidine, dicyandiamide, red prussiate of potash, formamine, triazole, and tetrazole; a capability improver can be magnesium carbonate, manganous carbonate, aluminium powder, powdered carbon, magnesium hydrate, metal oxide, etc.; and the bond adopts phenolic resin, etc. The preparation of the magnesium salt comprises the continuous steps: medium temperature and low pressure dehydration, spray under the protection of nitrogen-oxygen flow or ultrafine grinding of grinded colloid, and microencapsulated hydrophobic treatment, etc. Compared with the prior art, the fire-extinguishing composition has the advantages of low price, extensive source, fire-extinguishing capability of K-type composition, and low causticity and toxicity of the ultimate product of combustion.
Owner:SHAANXI J&R FIRE FIGHTING CO LTD
Compounds containing S-N-valeryl-N-{[2′-(1H-tetrazole-5-yl)-biphenyl-4-yl]-methyl}-valine and (2R,4S)-5-biphenyl-4-yl-4-(3-carboxy-propionylamino)-2-methyl-pentanoic acid ethyl ester moieties and cations
A compound of an angiotensin receptor antagonist (ARB), a neutral endopeptidase inhibitor (NEPi) and one or more monovalent cations are useful for the treatment of hypertension and / or heart failure. ARB includes S—N-valeryl-N-{[2′-(1H-tetrazole-5-yl)-biphenyl-4-yl]-methyl}-valine in the anion form, NEPi includes (2R,4S)-5-biphenyl-4-yl-4-(3-carboxy-propionylamino)-2-methyl-pentanoic acid ethyl ester in the anion form and cation includes monovalent cations such as Na+. The compound includes trisodium [3-((1S,3R)-1-biphenyl-4-ylmethyl-3-ethoxycarbonyl-1-butylcarbamoyl)propionate-(S)-3′-methyl-2′-(pentanoyl{2″-(tetrazol-5-ylate)biphenyl-4′-ylmethyl}amino)butyrate] hemipentahydrate.
Owner:NOVARTIS PHARM CORP
Polymers of intrinsic microporosity containing tetrazole groups
InactiveUS8623928B2Extending possible structureIncrease rangeOrganic chemistryOther chemical processesTetrazoleClick chemistry
The invention provides a tetrazole-containing polymer of intrinsic microporosity comprising (10) or more subunits, wherein one or more of the subunits comprise one or more tetrazolyl moieties. In one embodiment, a polymer of intrinsic microporosity (PIM-1) was modified using a “click chemistry” [2+3] cycloaddition reaction with sodium azide and zinc chloride to yield new PIMs containing tetrazole units. Polymers of the present invention are useful as high-performance materials for membrane-based gas separation, materials for ion exchange resins, materials for chelating resins, materials for superabsorbents, materials for ion conductive matrixes, materials for catalyst supports or materials for nanoparticle stabilizers.
Owner:NAT RES COUNCIL OF CANADA
Tetrazole compounds and pharmaceutical agents containing such derivative
PCT No. PCT / JP96 / 03801 Sec. 371 Date Jun. 29, 1998 Sec. 102(e) Date Jun. 29, 1998 PCT Filed Dec. 26, 1996 PCT Pub. No. WO97 / 24339 PCT Pub. Date Oct. 7, 1997A tetrazole derivative of formula (I) wherein R is H, alkyl, alkoxy, carbocyclic ring, alkyl or alkoxy substituted by carbocyclic ring; AA1 and AA2 is a bond or and respectively, or AA1 and AA2, together, may have the formula (a); and Y is formula (b) wherein the Tet ring is tetrazole; Z is alkylene, alkenylene, O, S, SO, SO2, NR26, methylene in alkylene replaced by O, S, -SO-, -SO2- or -NR26-; and E is H, alkyl, or COOR27.
Owner:ONO PHARMA CO LTD
Novel Tetrazole Derivatives as Positive Allosteric Modulators of Metabotropic Glutamate
The present invention relates to new tetrazole compounds of formula I wherein B, P, Q, W, R1 and R2 are defined in the description: invention compounds are useful for the treatment or prevention of central nervous system disorders as well as other disorders modulated by mGluR5 receptors.
Owner:ADDEX PHARM SA
Substituted basic metal nitrates in gas generation
A material for a pyrotechnic composition and related pyrotechnic compositions are provided in which the material includes a substituted basic metal nitrate including a reaction product of an acidic organic compound and a basic metal nitrate. A method for enhancing a burn rate of a gas generant composition and a burn rate enhanced gas generant composition including a reaction product of basic metal nitrate and tetrazoles, tetrazole derivatives, and combinations thereof, and a nitrogen-containing co-fuel such as guanidine nitrate are also disclosed. The burn rate enhance gas generant composition may optionally include an additional oxidizer such as basic copper nitrate.
Owner:AUTOLIV ASP INC
Polishing composition and method of polishing with the same
A polishing composition comprises: at least one compound selected from tetrazole compounds and derivatives thereof and anthranilic acid compounds and derivatives thereof; abrasive particles comprising associative abrasive particles; and an oxidizing agent.
Owner:FUJIFILM HLDG CORP +1
Method and solution for forming anatase titanium dioxide, and titanium dioxide particles, colloidal dispersion and film
InactiveUS20060254461A1Accelerated agingImprove propertiesPigmenting treatmentOther chemical processesTitanium chlorideTetrazole
A sol solution containing poly(titanic acid) and a planar heterocyclic ligand is provided. Titanium dioxide (TiO2) particles are formed by aging the sol solution at a temperature below about 140° C. The particles have metallocene-like Ti-complexes comprising the heterocyclic ligand and can be substantially in the anatase phase. The heterocyclic ligands can be triazole, tetrazole, or thiadiazole. The sol solution may be prepared by aging a precursor solution. The precursor solution may contain the heterocyclic ligands and a precursor for poly(titanic acid). The precursor may be titanium alkoxide or titanium chloride. The sol solution may also contain at least one of an organic acid, a base, and a surfactant. The aged sol solution may form a colloidal dispersion of the TiO2 particles. A photo-catalytic and transparent film may be formed from the TiO2 particles by depositing a layer of the colloidal dispersion on a support.
Owner:AGENCY FOR SCI TECH & RES
Blend polymeric membranes comprising tetrazole-functionalized polymer of intrinsic microporosity and polyethylene glycol
The present invention is for high permeance and high selectivity blend polymeric membranes comprising poly(ethylene glycol) (PEG) and a highly permeable polymer selected from the group consisting of polymers of intrinsic microporosity (PIMs), tetrazole-functionalized polymers of intrinsic microporosity (TZPIMs), or mixtures thereof. The present invention also involves the use of such membranes for separations of liquids and gases.
Owner:UOP LLC
Energetic coordination complex based on azo tetrazole azotetrazole and use thereof
InactiveCN101434617AImprove combustion performanceAchieve high energyOrganic-compounds/hydrides/coordination-complexes catalystsCopper organic compoundsTetrazoleO-PHENANTHROLINE
The invention discloses an azotetrazole-based energetic compound with the composition of M(ATZ)(L)n question mark mH2O, wherein, M refers to Mn, Co, Ni, Cu, Zn or Pb; ATZ refers to 5, 5'-azotetrazole ion, L refers to 1, 10-o-phenanthroline or 2, 2'-dipyridyl, n refers to 1 or 2, and m refers to an integer or a decimal between 0 and 10. In the invention, the 1, 10-o-phenanthroline or the 2, 2'-dipyridyl is introduced into the M(ATZ) as an ancillary ligand to obtain a novel compound, thus integrating the characteristics of high efficiency, insensibility and environmental protection of a catalyst on the premise of the combustibility improvement of composite propellants. The azotetrazole-based energetic compound has the advantages of simple preparation method and accessible raw materials.
Owner:NORTHWEST UNIV(CN)
Combination of rapamycin and its tetrazole isomers and epimers, methods of making and using the same
Epimers and isomers of tetrazole-containing rapamycin analogs are immunomodulatory agents and are useful in the treatment of restenosis and immune and autoimmune diseases. Also disclosed are cancer-, fungal growth-, restenosis-, post-transplant tissue rejection- and immune- and autoimmune disease-inhibiting compositions and a method of inhibiting cancer, fungal growth, restenosis, post-transplant tissue rejection, and immune and autoimmune disease in a mammal. It is preferred to use a combination of native rapamycin and its tetrazole containing isomers and epimers. One particular preferred application of such a combination of rapamycin and its tetrazole containing isomers and epimers is in medicated devices and local vascular delivery wherein the stability and lipid solubility and subsequently diffusion through tissue and cell membranes of the tetrazole isomers and epimers are essential to the success of the combined rapamycin formulation.
Owner:WYETH LLC
Silver plating anti-color changing protecting agent composition
InactiveCN101503798APrevent discolorationDoes not affect conductivityMetallic material coating processesBenzoxazoleSilver plate
The invention relates to a silver plating anti-tarnish protectant compound. The protectant compound comprises the following components in percentage by weight: 13 to 15 percent of aliphatic alcohol polyoxyethylene ether, 8 to 10 percent of 1-phenyl-pentasulfhydyl tetrazole, 4 to 5 percent of 2-sulfhydryl benzoxazole, 3 to 5 percent of t-dodecyl mercaptan, 3 to 5 percent of 2-sulfhydryl benzimidazole, 8 to 10 percent of anhydrous ethanol, 8 to 10 percent of ethylene glycol, and the balance of deionized water. The silver plating anti-tarnish protectant compound forms a protective complex film on a silver surface, has a higher corrosion inhibition rate, and obviously improves the sulfidation resistance and abrasion resistance of the silver surface. The silver plating anti-tarnish protectant compound is mainly used for the tarnish prevention of silvered electronic parts and components, and is also applied to the sulfidation and tarnish prevention of silver or silvered jewellery, jewelry, ornaments, artwork, tableware, and the like. The silver plating anti-tarnish protectant compound can effectively protect silvered articles against sulfidation and tarnish in a certain period, keep the original metal luster and has no influence on the conductivity and weldability of the parts.
Owner:JIANGXI SCI & TECH NORMAL UNIV
Passivative chemical mechanical polishing composition for copper film planarization
InactiveUS20050255693A1Semiconductor/solid-state device manufacturingPolishing compositions with abrasivesPhysical chemistryCompound (substance)
A CMP composition containing 5-aminotetrazole, e.g., in combination with oxidizing agent, chelating agent, abrasive and solvent and a method of use. Such CMP composition may be diluted during the CMP polish to minimize the occurrence of dishing or other adverse planarization deficiencies in the polished copper, even in the presence of substantial levels of copper ions in the CMP composition and at the copper / CMP composition interface during CMP processing.
Owner:ENTEGRIS INC
Polishing compound, method for polishing surface to be polished, and process for producing semiconductor integrated circuit device
InactiveUS20080200033A1High removal rateSuppress polishingPigmenting treatmentOther chemical processesO-Phosphoric AcidTetrazole
To provide a polishing compound which is capable of polishing SiC at a high removal rate, or capable of suppressing polishing of silicon dioxide in an insulating layer on the other hand, while polishing SiC at a high removal rate, in production of a semiconductor integrated circuit device, whereby it is possible to obtain a semiconductor integrated circuit device having a planarized multiplayer structure.The present polishing compound comprising abrasive particles (A), an adjusting agent of removal rate (B) which is at least one selected from the group consisting of a benzotriazole, a 1H-tetrazole, a benzene sulfonic acid, phosphoric acid or organic phosphonic acid, an organic solvent (C) having a relative permittivity of from 15 to 80, a boiling point of from 60 to 250° C. and a viscosity of from 0.5 to 60 mPa·S at 25° C., and water (D).
Owner:ASAHI GLASS CO LTD
Extruded styrene resin foam and process for producing the same
InactiveUS6841581B2Improve insulation effectGood environmental compatibilityFireproof paintsPhosphoric Acid EstersTetrazole
An extruded styrene resin foam which is produced by using a blowing agent imposing a reduced load on the environment and has outstandingly excellent thermal insulating property and flame retardant property adapted for construction use. The foam is obtained by extrusion-foaming of a styrene resin and characterized by containing at least, one or more of saturated hydrocarbons having 3 to 5 carbon atoms as a blowing agent, and containing (A) a halogenated flame retardant, and (B) at least one compound selected from the group consisting of phosphorus type flame retardants containing nitrogen atom in a molecule; tetrazole compounds; specific nitrogen-containing compounds; metal borates; boron oxides; phosphoric acid ester compounds, and having a cell structure constituting the foam wherein a cell anisotropic ratio k, which is defined by the formula: k=a / (a×b×c)1 / 3 wherein, in sections of the foam, a (mm) is an average cell size in the thickness direction, b (mm) is an average cell size in the transverse direction and c (mm) is an average cell size in the longitudinal direction, satisfies the relationship: k≦1.1, and a satisfies the relationship: 0.05≦a≦0.30, and the method for producing the same.
Owner:KANEKA CORP
Crystalline form of r)-3-(4-(2-(2-methyltetrazol-5-yl)pyridin- 5-yl)-3-fluorophenyl)-5-hydroxymethyl oxazolidin-2-one dihydrogen phosphate
ActiveUS20100227839A1Reduce filter timeImprove usabilityAntibacterial agentsOrganic active ingredientsPhosphateAntibacterial activity
A crystalline form of crystalline (R)-3-(4-(2-(2-methyltetrazol-5-yl)-pyridin-5-yl)-3-fluorophenyl)-5-hydroxymethyl oxazolidin-2-one dihydrogen phosphate, methods of making the crystalline form and pharmaceutical compositions comprising the crystalline form are useful antibiotics. Further, the derivatives of the present invention may exert potent antibacterial activity versus various human and animal pathogens, including Gram-positive bacteria such as Staphylococi, Enterococci and Streptococi, anaerobic microorganisms such as Bacteroides and Clostridia, and acid-resistant microorganisms such as Mycobacterium tuberculosis and Mycobacterium avium. Accordingly, the compositions comprising the crystalline form may be used in antibiotics.
Owner:MERCK SHARP & DOHME LLC
Ferrocene high-nitrogen ionic compound and preparation method thereof
InactiveCN102675376AImprove thermal stabilityImprove catalytic performanceMetallocenesSteam pressureTetrazole
Owner:SHAANXI NORMAL UNIV
Methods of administering tetrazole-containing rapamycin analogs with other therapeutic substances using medical devices
InactiveUS7399480B2Reduce probabilityReduces restenosis in vasculatureBiocideOrganic chemistryAnti plateletCytostatic drugs
A medical device comprising a supporting structure capable of containing or supporting a pharmaceutically acceptable carrier or excipient, which carrier or excipient may contain one or more therapeutic agents or substances, with the carrier preferably including a coating on the surface thereof, and the coating containing the therapeutic substances, such as, for example, drugs. Supporting structures for the medical devices that are suitable for use in this invention include, but are not limited to, coronary stents, peripheral stents, catheters, arterio-venous grafts, by-pass grafts, and drug delivery balloons used in the vasculature. Drugs that are suitable for use in this invention include, but are not limited to,This drug can be used in combination with another drug including those selected from anti-proliferative agents, anti-platelet agents, anti-inflammatory agents, anti-thrombotic agents, cytotoxic drugs, agents that inhibit cytokine or chemokine binding, cell de-differentiation inhibitors, anti-lipaedemic agents, matrix metalloproteinase inhibitors, cytostatic drugs, or combinations of these drugs.
Owner:ABBOTT LAB INC
Polishing liquid for metals
InactiveUS20070200089A1Increase speedHigh selectivityOther chemical processesSemiconductor/solid-state device manufacturingCrystallographyAryl
A liquid for polishing metals, which is used in the chemical and / or mechanical flattening of a semiconductor device, the polishing liquid being characterized in that it comprises at least one member selected from the group consisting of tetrazoles or triazoles represented by any one of the following general formulas (I) to (III):wherein, Ra represents at least one substituent selected from the group consisting of a sulfo, an amino, a phosphono, a carbamoyl, a carbamide, a sulfamoyl, and a sulfonamide group; Rb represents at least one substituent selected from the group consisting of a hydroxyl, a carboxyl, a sulfo, an amino, a phosphono, a carbamoyl, a carbamide, a sulfamoyl, and a sulfonamide group; and Lb represents a divalent connecting group; and Rc and Rd each independently represent a hydrogen atom or a substituent, and at least one of Rc and Rd represent a hydroxyl, a carboxyl, a sulfo, an amino, a phosphono, a carbamoyl, a carbamide, a sulfamoyl, and a sulfonamide group or a group: -La-Re; wherein La represents a divalent connecting group; Re represents a hydroxyl, a carboxyl, a sulfo, an amino, a phosphono, a carbamoyl, a carbamide, a sulfamoyl or a sulfonamide group; R and R′ each independently represent a group selected from the group consisting of a hydrogen atom, alkyl groups and aryl groups; and R″ independently represents a group selected from the group consisting of alkyl groups and aryl groups.
Owner:FUJIFILM CORP
Inhibitors of P2X3
Compounds of formula 1 are modulators of P2X3 useful for the treatment of pain and genitourinary, gastrointestinal, and respiratory disorders:whereinR1 is —C(═S)CH3, pyridyl, pyrimidinyl, pyrazinyl, thiazolyl, furyl, furylcarbonyl, acetyl, or carbamoyl; R2a and R2b are independently H, methyl, or ethyl; R3 is H or methyl; Y is a bond, —(CR4R5)n— or —CR4═CR5—; wherein R4 and R5 are each independently H or methyl and n is 1 or 2; X is N or CH; A is phenyl, 5-membered heterocyclyl, or 6-membered heterocyclyl; R6, R7 and R8 are each independently H, halo, lower alkyl, cycloalkyl, alkylthio, alkylthio-lower alkyl, alkylsulfonyl-lower alkyl, di(lower alkyl)amino-lower alkyl, morpholinyl-lower alkyl, 4-methyl-piperazinyl-methyl, trifluoromethyl, pyridyl, tetrazolyl, thiophenyl, phenyl, biphenyl, or benzyl (where thiophenyl, phenyl and benzyl are substituted with 0-3 lower alkyl, halo, sulfonamido, trifluoromethyl, lower alkoxy or lower alkylthio) or R6 and R7 together form a 5-membered or 6-membered carbocyclic or heterocyclic ring substituted with 0-3 substituents selected from the group consisting of lower alkyl, lower alkoxy, oxo, halo, thiophenyl-lower alkyl, phenyl, benzyl (where phenyl and benzyl are substituted with 0-3 lower alkyl, halo, sulfonamido, trifluoro-methyl, lower alkoxy, lower alkylthio, amino-lower alkyl, lower alkylamino-lower alkyl, or di(lower alkyl)amino-lower alkyl); and pharmaceutically acceptable salts thereof; wherein when R1 is pyrimidin-2-yl, X is N, Y is a bond and A is oxazol-5-yl the carbon atom at position 4 in said oxazol-5-yl is not substituted by propyl when the carbon atom at position 2 in said oxazol-5-yl is substituted by substituted phenyl and the carbon atom at position 4 in said oxazol-5-yl is not substituted by phenyl when the carbon atom at position 2 is substituted by unsubstituted or substituted phenyl.
Owner:ROCHE PALO ALTO LLC
Fire suppressing gas generator composition
InactiveUS20020137875A1Increase volumeReduce the temperatureOther chemical processesFire extinguisherElastomerParticulates
A fire suppressing gas generator composition which has a low burn temperature which provides an adjustable mass flow rate, which provides high inert gas yields upon combustion, which generates flame suppressing gasses during composition, which provides exhaust gas with low particulate content, and which is suitable for use in pellet form. The gas generator composition of the invention generally comprises a high nitrogen content solid, preferably 5-amino tetrazole, and potassium perchlorate or other oxidizer salt in an amount sufficient to allow flameless deflagration of the high nitrogen contant solid. The composition of the invention also preferably comprises a flame inhibitor precursor such as perbrominated aromatic compound, an elastomeric binder, a powder pressing modifier or enhancer such as mica, and an electrostatic charge suppressant such as graphite.
Owner:THE GOVERNMENT OF THE UNITED STATES OF AMERICA AS REPRESENTED BY THE SEC OF THE NAVY NAVAL RES LAB WASHINGTON
Gas generant and manufacturing method thereof
InactiveUS20050257866A1Improve solubilityPromote aggregationExplosive working-up apparatusPressure gas generationTriazole antifungalsTetrazole
The present invention generally relates to gas generant compositions for inflators of occupant restraint systems, for example. An extrudable pyrotechnic composition includes polyvinylazoles for use within an airbag gas generator. The fuel may be selected from exemplary polyvinylazoles including 5-amino-1-vinyltetrazole, poly(5-vinyltetrazole), poly(2-methyl-5-vinyl) tetrazole, poly(1-vinyl) tetrazole, poly(3-vinyl) 1,2,5 oxadiazole, and poly(3-vinyl) 1,2,4-triazole. An oxidizer is combined with the fuel and preferably contains phase stabilized ammonium nitrate. A novel method of forming the compositions is also presented wherein the various constituents are wetted and / or dissolved, and then cured within the polyvinylazole matrix thereby forming a more intimate combination within the gas generant composition. A vehicle occupant protection system 180, and other gas generating systems, incorporate the compositions of the present invention.
Owner:AUTOMOTIVE SYST LAB
Resin composition, printed circuit board using the composition, and method of manufacturing the same
ActiveUS20150050473A1Improve adhesionPhotosensitive materialsDecorative surface effectsTetrazolePhotoinitiator
A resin composition, a printed circuit board using the composition, and a method of manufacturing the printed circuit board. The resin composition includes: a photopolymerizable compound, such as one having an ethylenically unsaturated bond which is polymerizable in a molecule, a photoinitiator, and a surface-modified silica by an alkyl sulfonated tetrazole compound.
Owner:SAMSUNG ELECTRO MECHANICS CO LTD


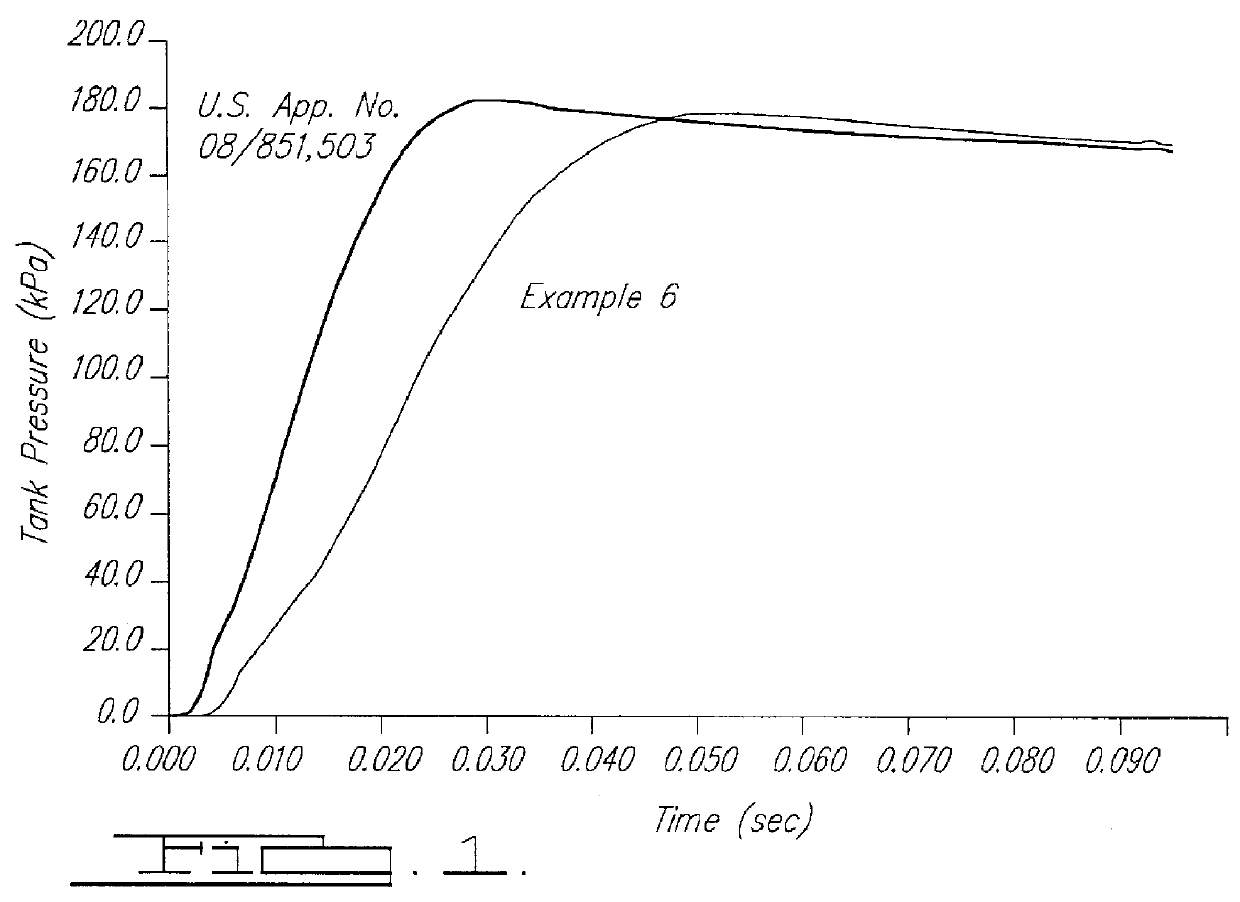
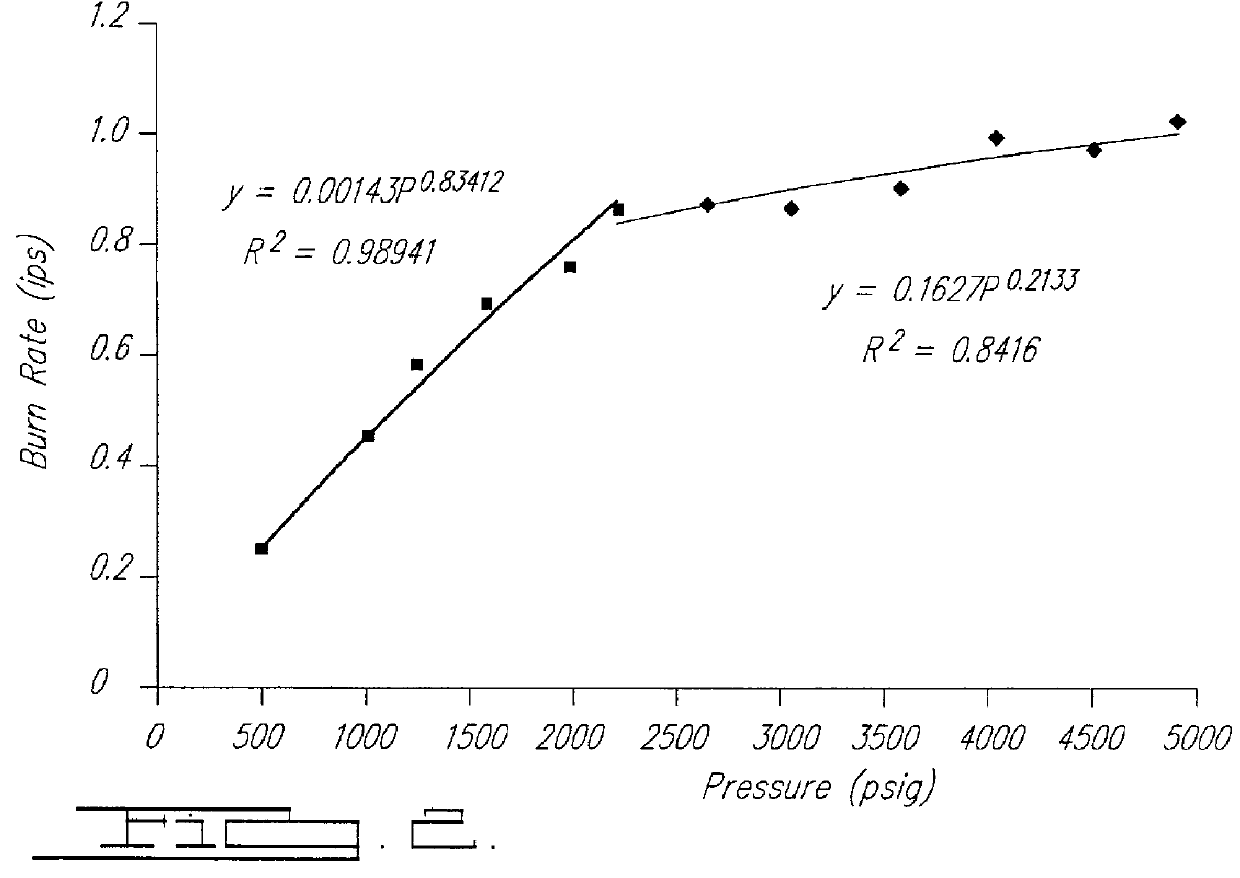


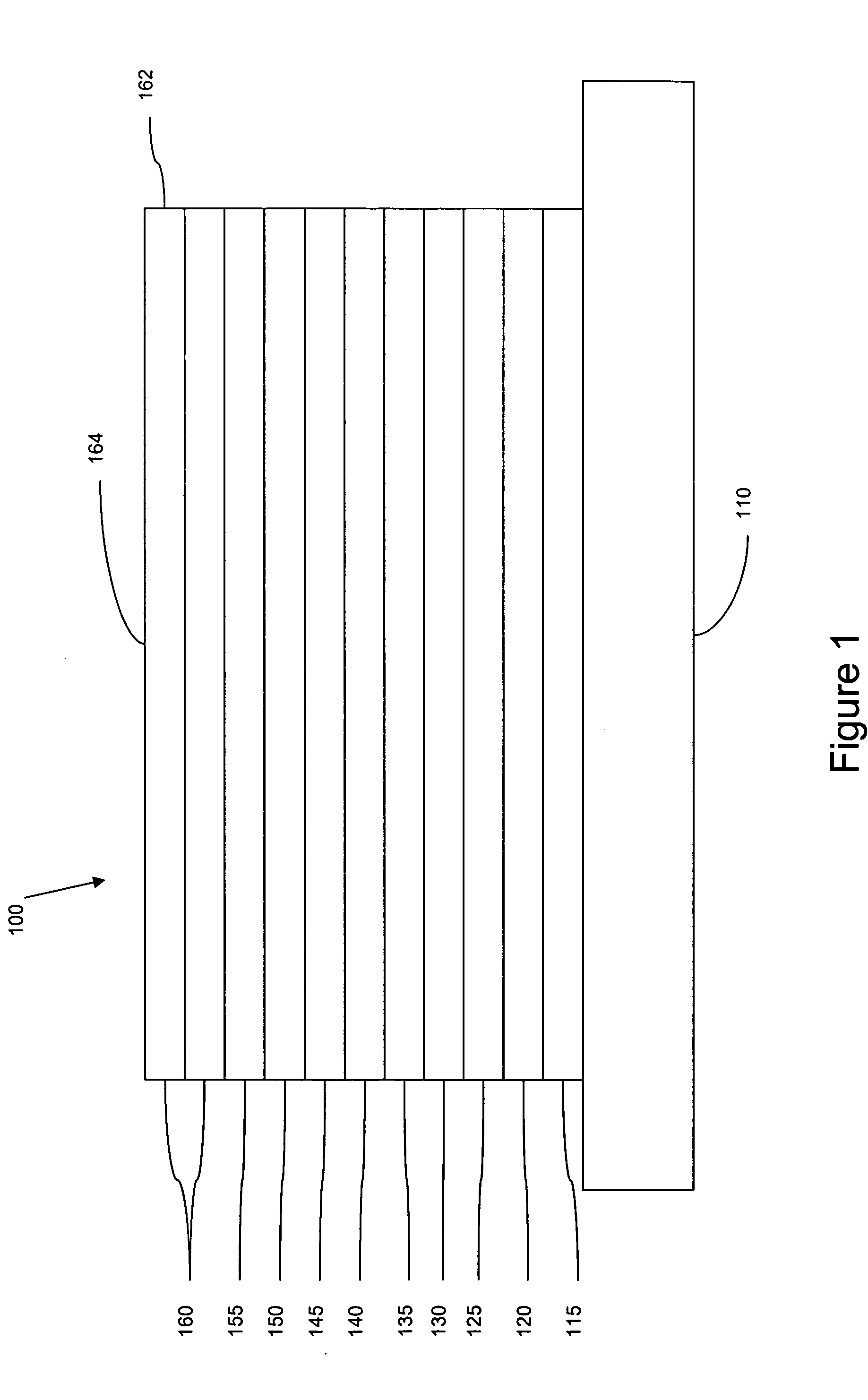


















![Compounds containing S-N-valeryl-N-{[2′-(1H-tetrazole-5-yl)-biphenyl-4-yl]-methyl}-valine and (2R,4S)-5-biphenyl-4-yl-4-(3-carboxy-propionylamino)-2-methyl-pentanoic acid ethyl ester moieties and cations Compounds containing S-N-valeryl-N-{[2′-(1H-tetrazole-5-yl)-biphenyl-4-yl]-methyl}-valine and (2R,4S)-5-biphenyl-4-yl-4-(3-carboxy-propionylamino)-2-methyl-pentanoic acid ethyl ester moieties and cations](https://images-eureka.patsnap.com/patent_img/eb239ae2-f451-4c9e-8101-694067a7ab8d/US08877938-20141104-D00000.png)
![Compounds containing S-N-valeryl-N-{[2′-(1H-tetrazole-5-yl)-biphenyl-4-yl]-methyl}-valine and (2R,4S)-5-biphenyl-4-yl-4-(3-carboxy-propionylamino)-2-methyl-pentanoic acid ethyl ester moieties and cations Compounds containing S-N-valeryl-N-{[2′-(1H-tetrazole-5-yl)-biphenyl-4-yl]-methyl}-valine and (2R,4S)-5-biphenyl-4-yl-4-(3-carboxy-propionylamino)-2-methyl-pentanoic acid ethyl ester moieties and cations](https://images-eureka.patsnap.com/patent_img/eb239ae2-f451-4c9e-8101-694067a7ab8d/US08877938-20141104-D00001.png)
![Compounds containing S-N-valeryl-N-{[2′-(1H-tetrazole-5-yl)-biphenyl-4-yl]-methyl}-valine and (2R,4S)-5-biphenyl-4-yl-4-(3-carboxy-propionylamino)-2-methyl-pentanoic acid ethyl ester moieties and cations Compounds containing S-N-valeryl-N-{[2′-(1H-tetrazole-5-yl)-biphenyl-4-yl]-methyl}-valine and (2R,4S)-5-biphenyl-4-yl-4-(3-carboxy-propionylamino)-2-methyl-pentanoic acid ethyl ester moieties and cations](https://images-eureka.patsnap.com/patent_img/eb239ae2-f451-4c9e-8101-694067a7ab8d/US08877938-20141104-C00001.png)